日前,中国科学院微电子研究所在锗基 MOS器件的研究上获得显著进展。
锗(Ge)材料具有优异的电子和空穴迁移率,是超高速、低功耗MOS 器件的理想沟道材料。对于高性能的MOS器件而言,良好的界面对于提升MOS器件的迁移率非常重要,由于high-k/Ge的界面稳定性较差,在界面处存在的大量的缺陷形成载流子的散射中心,阻碍了高迁移率的获得,进而严重影响器件的最终性能。
针对这个核心问题,中国科学院微电子研究所微波器件与集成电路研究室(四室)刘洪刚研究员带领的研究团队,通过对Ge表面进行化学钝化处理,然后进行ALD-Al2O3的沉积,获得了具有较低缺陷密度的界面。基于此方法,分别在Ge(100), Ge(110)和Ge(111)衬底上制造了Ge-pMOSFET,其空穴迁移率得到大幅度的提升 (图1)。特别是在Ge(111)衬底上,通过化学钝化,成功使得峰值迁移率达到660 cm2V-1s-1,该迁移率为体硅迁移率的3.5倍,达到了世界先进水平。
此外,该团队与日本东京大学鸟海研究小组合作,系统地研究了high-k/Ge界面的反应机理。通过XPS表征的手法,首次阐明了GeO歧化反应(2GeO→GeO2+Ge)以及GeO2/Ge界面处氧化还原反应(GeO2+Ge→2GeO)的反应机理,成功建立Ge及其氧化物体系的反应动力学模型(图3)。相关成果发表在2012年8月份的应用物理快报杂志上(S. K. Wang, H. G. Liu, A. Toriumi, Applied Physics Letters, 101, 061907 (2012))
该研究团队在锗(Ge)基 MOS器件得理论和应用研究方面已取得一系列科研成果,其科研文章发表在Applied Physics Letters、SSDM、ECS、ICSICT、物理学报等多家期刊和学术会议上,已申请专利10余项,为进一步开展高迁移率低功耗器件及其集成的研究奠定了良好的工作基础。
相关代表论文:
1. S. K. Wang, H.-G. Liu, and A. Toriumi, "Kinetic Study of GeO Disproportionation into GeO2/Ge System Using X-ray Photoelectron Spectroscopy", Appl. Phys. Lett. 101, 061907 (2012)
2. B. Q. Xue, H. D. Chang, B. Sun, S. K. Wang, and H. G. Liu, " The Impact of HCl Precleaning and Sulfur Passivation on the Al2O3/Ge Interface in Ge Metal-Oxide-Semiconductor Capacitors", Chin. Phys. Lett. 29, 046801 (2012)
3. S. K. Wang, B. Q. Xue, H. L. Liang, Z. X. Mei, Y. Li, W. Zhao, B. Sun, X. L. Du, H. G. Liu, "Growth of Epitaxial Beryllium Oxide on Ge (111) by Molecular Beam Epitaxy", Accepted by Ext. Abst. Int. conf. on Solid State Devices and Materials (SSDM2012), (Sep 2012, Tokyo).

图1 盐酸钝化Ge(100), Ge(111), Ge(110)制备的PMOSFET器件的有效迁移率与衬底有效载流子浓度的关系
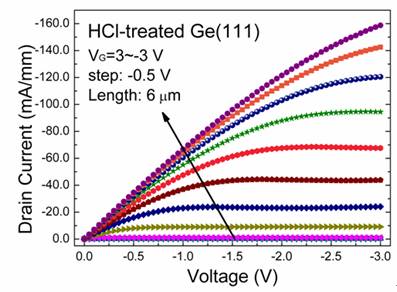
图2 HCl处理的Ge(111)衬底的MOSFET的I-V曲线

图3 GeO歧化反应以及GeO2/Ge界面处氧化还原反应的反应动力学模型
综合信息