
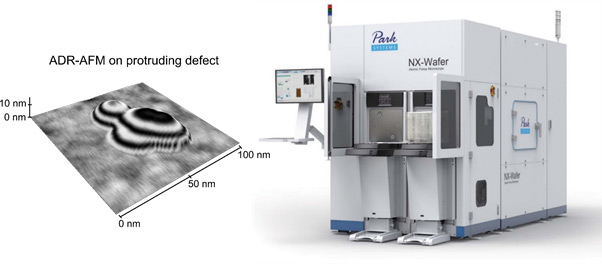
基于AFM的缺陷检查的最大挑战之一是将缺陷坐标从AOI转移到AFM。最初手动标记的方法很耗时,并且显着降低了吞吐量。另一方面,使用AFM进行的自动缺陷检查可从AOI数据中导入缺陷的坐标。导入缺陷坐标需要晶片的精确对准以及AOI和AFM之间的平台误差补偿。具有比AOI更高的位置精度的光学分析工具(例如candela)可以在快速的中间校准步骤中减少载物台误差。ADR-AFM测量包括在给定缺陷坐标处的大规模调查扫描,缺陷的高分辨率图像以及缺陷分类。由于具有自动化功能,因此更加简便,效率更高。为了维持纳米范围的笔尖半径,并为后续扫描提供高分辨率,ADR-AFM使用了非接触式动态成像模式,因此,ADR-AFM可以防止烙铁头磨损,并确保对缺陷进行定量检查。
比较AOI和ADR-AFM
研究人员比较了用AOI和ADR-AFM对相同纳米尺寸缺陷进行缺陷检查的结果。虽然AOI根据散射光的强度估算缺陷的大小,但ADR-AFM可以通过机械扫描直接对缺陷成像,除横向尺寸外,ADR-AFM还可以测量缺陷的高度或深度,从而可以区分突出的“凸点”和缩进的“凹痕”缺陷。缺陷的三维形状的可视化可确保可靠的缺陷分类,这是无法通过AOI实现的。
比较ADR-SEM和ADR-AFM
除了ADR-AFM,还可以使用ADR-SEM进行高分辨率缺陷检查。ADR-SEM通过SEM测量基于AOI数据的DOI坐标进行自动缺陷检查,在此期间高能电子束扫描晶圆表面。尽管SEM具有较高的横向分辨率,但通常无法提供有关缺陷的定量高度信息。
为了比较ADR-SEM和ADR-AFM的功能,首先通过ADR-SEM对晶片的相同区域进行成像,然后再进行ADR-AFM测量。由于ADR-AFM中ADR-SEM扫描区域的可见性,ADR-SEM遗漏了一个突出的缺陷。此外,具有高垂直分辨率的ADR-AFM表现出足够的灵敏度来检测高度低至0.5 nm的表面缺陷。由于缺乏垂直分辨率,这些缺陷无法通过ADR-SEM成像。ADR-SEM扫描区域可以在ADR-AFM图像中识别为缺陷周围的矩形。相比之下,无创成像和高垂直分辨率使ADR-AFM成为缺陷检查的表征技术的理想之选。
结论
原子力显微镜测量的自动化简化了缺陷表征中原子力显微镜的先前耗时的工作流程。AFM自动化的进步是引入ADR-AFM的基础,其中可以从先前的AOI测量中导入缺陷坐标,并且随后的基于AFM的表征不需要用户在场。因此,ADR-AFM有资格作为一种在线方法进行缺陷检查。特别是对于一位或两位数纳米范围内的缺陷尺寸,ADR-AFM补充了传统的AOI、AFM的高垂直分辨率有助于三维缺陷的分类。非接触式测量模式可确保无创表面特征并防止AFM尖端磨损,从而确保在许多连续测量中均保持高分辨率。
学习园地