
应用材料公司是第一家在 2016 年推出下一代选择性蚀刻系统(有时称为高选择性蚀刻)的供应商。现在,Lam Research、TEL 和其他公司正在推出具有高选择性蚀刻能力的工具,为未来的设备做准备例如 3D DRAM 和环栅晶体管。
通过高选择性蚀刻,专用蚀刻工具在 IC 生产过程中去除或蚀刻掉微小芯片结构中的材料。此外,这些高选择性蚀刻工具能够在任何方向(各向同性)去除材料,而不会损坏器件的其他部分。在某些情况下,高选择性蚀刻工具也可以在一个方向(各向异性)去除材料。今天,一些现有的蚀刻工具可以在一定程度上进行选择性蚀刻,但它们在这方面的能力有限,无法在高级节点上创建新的器件结构。
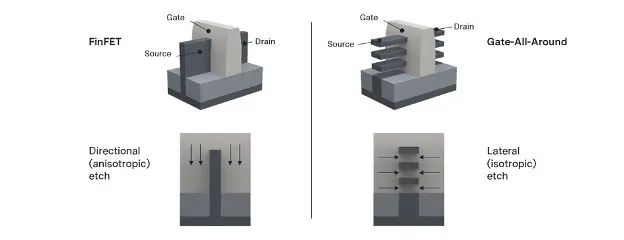
图 1:从finFET到GAA 的过渡推动了关键的各向同性选择性蚀刻要求。资料来源:LAM Research
使用了几十年,蚀刻是晶圆厂中必不可少的工艺。在一个简单的工艺流程中,系统将二氧化硅材料沉积在晶圆上。然后,光刻系统在晶圆上每个裸片的材料上形成微小特征图案,蚀刻工具去除每个裸片上不需要的材料,以创建各种结构,以达到埃级精度 (1? = 0.1nm) 的目标。

图 2:晶圆厂中的一般图案化和蚀刻工艺步骤。
资料来源:维基百科
基本上,先进的蚀刻工具是一个带有腔室的独立系统。在操作中,将晶片插入腔室中。在一种类型的蚀刻中,等离子体(一种电离气体)在腔室中产生。“首先,我们制造等离子体。电子撞击气体分子。这会产生离子和更多的电子。它们还会产生自由基。自由基成为在等离子体蚀刻系统中进行化学蚀刻的物质。这些自由基扩散到晶片表面。它可能会与一种材料发生反应,但不会与另一种材料发生反应。最后,你有一个蚀刻。结果是一个各向同性的过程。如果化学成分合适,它的选择性就会非常高,”Fractilia 的首席技术官 Chris Mack 在视频演示中解释道。基本上,自由基是原子、分子或离子。
并非所有芯片工艺都需要高度选择性的蚀刻。在芯片生产中,许多蚀刻步骤很简单,并且使用现有的蚀刻工具。对于要求更高的芯片工艺,蚀刻供应商提供了涉及更复杂工具的各种选项。高选择性蚀刻就是这样一种选择。使用专有化学物质,具有这些功能的蚀刻工具可以去除目标材料,而无需修改或去除周围层。
这个过程类似于原子层蚀刻 (ALE),但它们在许多方面都不同。基本上,ALE 在原子尺度上选择性地去除目标材料。“在 ALE 中,你试图一次移除一个原子层。TechInsights 的副主席Dan Hutcheson 说,您拥有极高的一致性,而且您不必移除整个薄膜。“通过选择性蚀刻,您将在薄膜上敲打直到它完全消失。选择性蚀刻的优点是你可以走得更快。关键是你不能损坏它下面或周围的东西。”
选择性蚀刻还涉及其他因素。“根据定义,当你蚀刻时,选择性是你想要去除的东西和你不想去除的东西之间的比率,”Hutcheson 说。
在一个示例中,芯片制造商将二氧化硅材料沉积在基板上。芯片制造商希望在设备中间保留该材料的选定部分,但希望移除其余部分。为此,将光刻胶掩模材料沉积在中间部分上。
在蚀刻过程中,腔室中的蚀刻剂(等离子体、气体/蒸汽、酸)轰击晶片。蚀刻物质对掩模材料的反应较慢,但与暴露的二氧化硅反应较快并去除。
选择性是指暴露材料与其底层或暴露材料与相邻材料之间的反应性差异。换句话说,根据 Plasma-Therm 公司的设备制造商 Corial 的说法,选择性是任何两种材料之间蚀刻速率的比率。
“选择性蚀刻是指以 >1000:1 的极高选择性去除材料的过程,并且材料损失很小:<2? 或一个单层原子。综上所述,正常的蚀刻选择性在 20:1 范围内,”Lam Research 产品营销总监 Ian Latchford 说。
尽管如此,越来越多的应用需要高度选择性的蚀刻。所有这些都需要具有复杂化学成分的专用且昂贵的选择性蚀刻工具。
蚀刻模式
根据 TechInsights 的数据,总体而言,全球蚀刻市场从 2020 年的 140 亿美元增长到 2021 年的 199 亿美元。据该公司称,蚀刻市场预计在未来五年内将以每年 7% 的速度增长。AMEC、应用材料、日立、Lam、Plasma-Therm 和 TEL 都是蚀刻业务的参与者。
在 IC 行业的早期,芯片制造商制造自己的设备。根据现在隶属于 TechInsights 的 VLSI Research 的历史资料,在过去,蚀刻工艺是在通风橱下的水槽中进行的。基本上,晶圆被浸入充满化学蚀刻剂的水槽中,然后冲洗。这去除了晶片上的材料。
在 1960 年代后期,现已倒闭的芯片制造商 Signetics 进行了最早的等离子蚀刻工作。到 1970 年代,出现了几家商业蚀刻设备供应商。
早期,蚀刻技术演变成两个部分——湿法蚀刻和干法蚀刻。在一个系统中,湿法蚀刻通过将晶片浸入液体溶液中来去除材料。
干法蚀刻是两个市场中较大的一个,广泛用于当今芯片的生产。干法蚀刻分为三个部分或模式——等离子蚀刻、反应离子蚀刻 (RIE) 和溅射蚀刻(又名离子束蚀刻)。每种模式用于不同的应用。
从技术上讲,选择性蚀刻是一种应用,而不是一个单独的类别。它适用于湿蚀刻和干蚀刻类别。在所有情况下,目标都是在晶圆上进行具有良好均匀性的精确蚀刻。
溅射或离子束蚀刻是一个物理过程。在操作中,将芯片插入系统中。该工具以加速的速度产生离子,从而去除芯片中的材料。
RIE 开发于 1970 年代,是一种等离子体工艺,广泛用于当今的芯片中。在操作中,离子在系统中产生,然后轰击晶片的表面。这反过来又会去除芯片中的材料。
与此同时,等离子蚀刻则不同。“在这个系统中,第一步是产生高密度等离子体,它由许多不同反应性的电子、离子和中性物质组成,”Imec 蚀刻研发工程师 Philippe Bézard 说。“然后,您可以使用离子过滤器(可视化一个带有小孔的板)或对晶圆施加更大的气体压力来过滤掉离子,让时间中和离子。”
剩余的自由基在晶片表面上扩散,然后被吸收。“来自底物的原子和来自气相的其他分子之间会发生反应,形成挥发性分子,”Bézard 说。
每种蚀刻模式都有不同的属性,例如选择性和方向性。方向性涉及各向异性和各向同性蚀刻。
“(在溅射蚀刻中),我们可以获得高各向异性,但不能获得高选择性,”Fractilia 的 Mack 解释说。“RIE 可以产生良好的选择性、高各向异性和适中的蚀刻速率。控制有时很困难。”
有时,芯片制造商需要更多的单向和选择性蚀刻。这就是等离子体蚀刻的用武之地。“一般来说,这个过程是各向同性的,具有潜在的高选择性,”Mack说。“为了获得更高的选择性,我们需要化学。”

图 3:各向同性或多向蚀刻(顶部)与各向异性或定向蚀刻(底部) 来源:维基百科
ALE 与选择性蚀刻
许多先进芯片都需要高度选择性蚀刻。多年来,半导体行业为存储器和逻辑开发了新的复杂器件。
从 2011 年开始,一些代工供应商开始提供使用最先进的 finFET 晶体管的先进工艺。IC 供应商已经围绕 finFET 开发了芯片。如今,代工厂客户正在出货使用 16nm/14nm、7nm 和 5nm 工艺节点的 finFET 的芯片。3nm finFET 正在研发中。
此外,在 3nm 和/或 2nm,一些代工厂将迁移到环栅 (GAA),这是一种速度更快的晶体管,比 finFET 消耗更少的功率。但 GAA FET 也更昂贵且更难制造。
与此同时,内存制造商正在开发更先进的 3D NAND、DRAM 和各种下一代内存类型。
这些设备给设备制造商带来了巨大的制造挑战,这正在影响更先进的工艺和工具的开发。对于先进的晶体管和最新的 DRAM,芯片制造商正在使用极紫外 (EUV) 光刻技术,这是一种 13.5nm 波长系统,用于对芯片中的微小特征进行图案化。
沉积和蚀刻工具的供应商也面临着一些挑战。“有很多过程挑战,”TEL 技术人员的高级成员罗伯特克拉克在最近的 IEDM 会议上发表演讲时说。“每一代都会导致我们必须处理的长宽比越来越高。这会产生各种蚀刻问题。你也有沉积问题。你的沉积物有保形、空隙和接缝。在蚀刻过程中会出现弯曲、弯曲、加载和选择性问题。”
幸运的是,蚀刻供应商已经开发出几种新功能来应对这些挑战。ALE 和高选择性蚀刻是其中的创新。
经过多年的研发,蚀刻供应商在 2010 年代中期引入了 ALE 工艺。ALE 在原子尺度上选择性地去除目标材料。
在 ALE 的一个示例中,晶片位于 ALE 系统的腔室中。第一步是在腔室的硅表面上注入氯气。氯分子被吸附在表面上,从而改变了表面。然后,将氩离子注入腔室,轰击表面并去除改性层。
有两种类型的 ALE——等离子和热。正在生产中的等离子 ALE 可实现各向异性蚀刻。仍在生根的热 ALE 使用热反应进行各向同性蚀刻。
“等离子或热 ALE 更多的是对蚀刻前沿的极端控制,而不是整体选择性,”Imec 的 Bézard 说。“有时它比传统的等离子蚀刻更好,有时它更糟。但选择性远低于高选择性蚀刻所需和实现的水平。”
此外,ALE 速度慢,各向同性能力有限。在某些情况下,ALE 可以对结构造成最小的损害。
高选择性蚀刻是不同的。“高选择性蚀刻本身就是一种蚀刻方法。高选择性蚀刻是一种技术,可以实现选择性是最重要规格的应用,”Imec 的 Bézard 说。
多年来,选择性蚀刻一直用于芯片生产,但技术有限。“在引入早期选择性蚀刻系统之前,想要进行各向同性蚀刻的芯片制造商会使用湿法蚀刻,”Lam 的 Latchford 说。“但湿法蚀刻在精度、控制和材料方面极为有限,根本无法创造芯片制造商继续向更小节点演进所需的新器件结构。”
随着时间的推移,该行业开发了使用干法蚀刻的选择性蚀刻工艺。今天,Applied、Lam、TEL 和其他公司提供具有下一代选择性蚀刻功能的工具。供应商对同一进程使用不同的名称。有人称其为极端选择性蚀刻、高度选择性蚀刻或精密选择性蚀刻。但它们都使用专用的腔室来实现使用专有化学物质的高选择性蚀刻。腔室安装在标准蚀刻平台上。
对于其选择性蚀刻系统,Applied 使用两步方法来实现各向同性蚀刻。首先,对表面进行处理。然后,产生自由基,从而去除目标材料。
“基于自由基的方法提供了极高的选择性。它可以蚀刻一种材料而不接触另一个表面,”应用材料公司副总裁 Uday Mitra 在 2017 年的一次采访中解释道。
与此同时,Lam 最近推出了三种选择性蚀刻产品——Argos、Prevos 和 Selis。Prevos 使用新颖的化学物质为氧化物、硅和金属提供选择性蚀刻。Selis 采用自由基和热蚀刻能力进行选择性蚀刻。Argos 选择性地修改和净化晶圆表面。
高选择性蚀刻可用于存储器和逻辑器件的各向异性或各向同性应用。每个应用程序也可以具有不同的选择性。
“这完全取决于所使用的蚀刻应用和类型,”Imec 的 Bézard 说,“对于等离子蚀刻,不同聚合物之间 50:1 的选择性被认为是非常高的。通常<10:1。例如,当使用循环工艺(通常 >300:1)蚀刻硅对氧化物的选择性时,这将被认为非常低。”
无论应用程序如何,所有过程都具有挑战性。“有一种通用蚀刻,它具有一定的选择性。然后,当您进行选择性蚀刻时,您所谈论的是多个数量级的更高选择性,”TechInsights 的 Hutcheson 说。“当你进行纯粹的选择性蚀刻时,它更接近于纯粹的化学过程。但现在你必须弄清楚如何使化学作用发挥作用。您想过度蚀刻一点,以确保清除所有材料。但是你不能走得太远,否则你将开始移除底层材料。您越能提高选择性,就越能确保在 300 毫米晶圆上进行均匀蚀刻。我们谈论的是我们处理的埃,就我们必须跨越 300 毫米水的精度而言。精度是惊人的。”
应用
高选择性蚀刻有多种应用程序。例如,使用各向异性高选择性蚀刻形成自对准触点。在芯片中,触点是连接晶体管与器件中第一层铜互连的微小结构。
同时,在 2020 年,TEL 和 Imec 发表了一篇关于硅修整应用的各向同性无等离子体工艺的论文。基本上,蚀刻工具修整薄膜或材料以形成所需的结构形状。该工艺可用于 finFET 和 GAA。
GAA 中使用了其他选择性蚀刻工艺。在 3nm和/或 2nm工艺节点,领先的代工厂及其客户最终将迁移到称为纳米片 FET 的 GAA 晶体管类型。纳米片 FET 是一种已旋转 90 度的 finFET,从而形成水平堆叠的鳍,每个鳍之间具有垂直栅极材料。每个鳍片都像一张纸,是一个通道。
为了在晶圆厂中制造纳米片,外延工具在基板上沉积超薄、交替的硅锗 (SiGe) 和硅层,形成超晶格结构。这种结构可能具有三层、五层或更多层的每种材料。
微小的垂直鳍在超晶格结构中被图案化和蚀刻。然后,形成内间隔物。为此,超晶格结构中的SiGe层的外部被凹陷,然后用介电材料填充。
KLA 工艺控制解决方案总监 Andrew Cross 表示:“内部间隔模块提供了对有效栅极长度的控制,并将栅极与源极/漏极外延隔离开来。” “在内隔板形成的每个步骤中,精确控制压痕和最终隔板凹槽的形状和 CD 对于确保正确的器件性能至关重要。”
接下来,形成源极/漏极。然后,去除超晶格结构中的 SiGe 层,留下构成通道的硅基层或片。
Onto Innovation 战略项目高级总监 Scott Hoover 说:“通道释放需要单独控制板材高度、角侵蚀和通道弯曲。”
最后,通过沉积高k电介质和金属栅极材料形成栅极。每个步骤都提出了一些挑战,特别是内部间隔和通道释放过程。
“对于纳米片器件制造中的每个关键步骤,关键是采用高度选择性的气相蚀刻工艺,”IBM Research 的高级技术人员 Nicolas Loubet 说。“关于沟道释放,需要 >150:1 的 SiGe 与 Si 蚀刻选择性以防止纳米片硅沟道损失,这可能导致迁移率下降、高沟道电阻和具有不同纳米片宽度的器件之间的大可变性。蚀刻工艺还需要以受控的蚀刻速率完全蚀刻小腔中的 SiGe,并且不应成为自限性。”
在最近的一篇论文中,IBM 和 TEL 展示了一种用于 GAA 的横向干法蚀刻技术,该技术使用新型化学物质,可实现 >150:1 的选择性。
与此同时,Lam 还开发了一种用于 GAA 内部间隔和释放步骤的高选择性蚀刻工艺。例如,对于通道凹槽步骤,Lam 结合了其新的 Prevos 和 Selos 工具。
“在 GAA 结构中,仅去除了 SiGe 材料层,而器件的其他每一块都相对保持不变。有了这种能力,芯片制造商可以雕刻出需要埃级精度的纳米级特征,以避免在蚀刻过程中去除、修改或损坏其他关键材料层,”Lam 的 Latchford 说。
无论工具供应商如何,这都是一个艰难的过程。“挑战不在于找到化学物质,”Imec 的 Bézard 说。“对于每个纳米片,它也获得了完全相同的选择性,因为底部的纳米片将比顶部的纳米片看到更多的蚀刻气体与基板的相互作用。所以你可以有非常局部的差异。这就是我们需要魔法的地方。我们需要确保每个纳米片都能看到与其他纳米片相同的东西。”

图 4:Lam的 Selis-Prevos 系统在纳米片 FET 和其他工艺中蚀刻 SiGe/Si 叠层。资料来源:Lam
未来器件
未来器件也需要高度选择性蚀刻,例如互补 FET (CFET),一种 3D 堆叠逻辑器件。CFET 目前处于研发阶段。
内存是另一个应用程序。今天,内存制造商正在推进 DRAM 扩展的下一阶段,但随着技术接近其物理极限,他们面临着一些挑战。
作为回应,存储器制造商正在开发 3D DRAM,它在许多方面类似于 3D NAND。3D DRAM 距离量产还有几年的时间。“在 3D DRAM 中,重大的设计变化解决了平面设计中面临的许多缩放问题,同时,也产生了对横向选择性蚀刻的巨大需求,”Lam 的 Latchford 说。
结论
可以肯定的是,业界正在开发一系列未来的设备。芯片制造商需要在多个领域使用更先进的工具,例如沉积、检测、光刻和计量。
高选择性蚀刻是工具组合的重要补充。“这些解决方案使芯片制造商能够制造出功能越来越强大和复杂的芯片,这些芯片可以支持计算和性能密集型技术,例如自动驾驶汽车、先进的数字医疗保健和即将到来的元宇宙,”Latchford 说。
| 相关新闻: |
| 新六边形硅有望催生下一代电子与能源设备 |
| 新研究向下一代脑机接口系统迈出重要一步 |
| 下一代储备池计算速度提高百万倍 |
学习园地